半导体VCSEL再生长型
发布时间:2008/12/5 0:00:00 访问次数:437
制作折射率导引型结构的vcsel,需要改变光腔周围的折射率。这可以通过刻蚀/再生长工艺来实现,其基本原理就是在光腔周围生成一个新的半导体材料(折射率也随之变化),起到光场的横向限制作用,如图所示。具体步骤为先制作刻蚀掩模(sio2,sinx),将光腔刻蚀成柱型,然后在刻蚀掉的地方通过再次外延工艺生长出新的材料。
刻蚀/再生长结构除了对出射光有着良好的限制作用外,还可以对注入电流进行有效的横向限制,并且钝化有源区的侧面及有着良好的热沉特性。然而,由于构成dbr的algaas非常容易受到诸如化学工艺、离子轰击及空气氧化等因素的影响,这些都会对外延生长造成影响。尤其是algaas表面氧化层非常难去除。因此在进行外延生长工艺之前,需要进行特殊的清除及刻蚀处理,并避免将器件暴露在空气中。
在高a1组分的vcsel上进行再生长的可行方法有3种。
第一种方法是掩埋异质结型vcsel,先用干法刻蚀,再用液相外延(lpe)生长。只是lpe中所用到的回熔清除工艺难以控制,不利于制作小尺寸的vcsel。而且lpe只能再gaas上外延生长,因此需要非常深的刻蚀(≥8 μm),并且还要再生长几个;μm的材料才能覆盖谐振腔。
第二种方法是原位干法刻蚀和mbe再生长。将刻蚀设备和mbe的生长室用一个超高真空环境的传送装置连接,以避免a1gaas表面与空气的接触。采用此工艺可以得到良好的生长质量,不好的方面是,整个设备都需要置于真空环境中,操作复杂且成本较高。
第三种方法是先用干法刻蚀和化学刻蚀去除光腔周围的材料,然后再用mocvd外延生长。mocvd的一个主要优点就是可以选择区域生长(可以抑制在掩模材料上生长),因此被看做是一个理想的制作平台。然而,用mocvd在高al组分algaas上再生长,需要预先进行严格的非选择性和控制性良好的刻蚀工艺。比较好的办法就是在干法刻蚀完成后,再用湿法刻蚀去掉氧化层,之后立刻送入mocvd反应室。
欢迎转载,信息来自维库电子市场网(www.dzsc.com)
制作折射率导引型结构的vcsel,需要改变光腔周围的折射率。这可以通过刻蚀/再生长工艺来实现,其基本原理就是在光腔周围生成一个新的半导体材料(折射率也随之变化),起到光场的横向限制作用,如图所示。具体步骤为先制作刻蚀掩模(sio2,sinx),将光腔刻蚀成柱型,然后在刻蚀掉的地方通过再次外延工艺生长出新的材料。
刻蚀/再生长结构除了对出射光有着良好的限制作用外,还可以对注入电流进行有效的横向限制,并且钝化有源区的侧面及有着良好的热沉特性。然而,由于构成dbr的algaas非常容易受到诸如化学工艺、离子轰击及空气氧化等因素的影响,这些都会对外延生长造成影响。尤其是algaas表面氧化层非常难去除。因此在进行外延生长工艺之前,需要进行特殊的清除及刻蚀处理,并避免将器件暴露在空气中。
在高a1组分的vcsel上进行再生长的可行方法有3种。
第一种方法是掩埋异质结型vcsel,先用干法刻蚀,再用液相外延(lpe)生长。只是lpe中所用到的回熔清除工艺难以控制,不利于制作小尺寸的vcsel。而且lpe只能再gaas上外延生长,因此需要非常深的刻蚀(≥8 μm),并且还要再生长几个;μm的材料才能覆盖谐振腔。
第二种方法是原位干法刻蚀和mbe再生长。将刻蚀设备和mbe的生长室用一个超高真空环境的传送装置连接,以避免a1gaas表面与空气的接触。采用此工艺可以得到良好的生长质量,不好的方面是,整个设备都需要置于真空环境中,操作复杂且成本较高。
第三种方法是先用干法刻蚀和化学刻蚀去除光腔周围的材料,然后再用mocvd外延生长。mocvd的一个主要优点就是可以选择区域生长(可以抑制在掩模材料上生长),因此被看做是一个理想的制作平台。然而,用mocvd在高al组分algaas上再生长,需要预先进行严格的非选择性和控制性良好的刻蚀工艺。比较好的办法就是在干法刻蚀完成后,再用湿法刻蚀去掉氧化层,之后立刻送入mocvd反应室。
欢迎转载,信息来自维库电子市场网(www.dzsc.com)
上一篇:半导体VCSEL选择氧化型
上一篇:半导体VCSEL离子注入型
 热门点击
热门点击
- Bi-CMOS微电子技术简介
- 半导体电致发光基础理论
- 分布反馈激光器(DFB-LD)
- 全半导体布拉格反射镜简介
- 交流电流测量电路的工作原理
- SOI微电子技术简介
- VCSEL光腔的设计
- 接触式/接近式光刻机
- 光发射器件能带结构
- 硅基半导体激光器
 推荐技术资料
推荐技术资料
- FU-19推挽功放制作
- FU-19是国产大功率发射双四极功率电二管,EPL20... [详细]


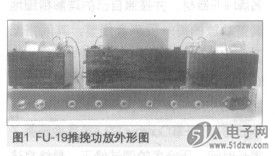
 公网安备44030402000607
公网安备44030402000607





