万亿级晶体管晶圆级处理器
发布时间:2020/7/8 21:31:33 访问次数:748
3D SoIC后端服务后,还开发了主要用于超级计算AI芯片的InFO_SoW(晶圆上系统)技术,并有望在两年内以InFO(集成式扇出封装技术)衍生的工艺开始量产。此前,台积电已与Cerebras达成合作,InFO衍生的工艺开始量产意味着台积电可能在两年内开始商业化生产专用于超级计算机的AI芯片。
这款从去年推出就备受瞩目的超级AI芯片若进入商业化,机器学习或将迈入新台阶。
制造“超级”AI芯片,面临互连难题
SABC167CRLMT6GA此次台积电计划生产的AI芯片,其实是由一家初创人工智能公司Cerebras Systems在去年推出的世界上最大的半导体芯片,该芯片拥有1.2万亿个晶体管,40万个核心,面积为46225平方毫米,片上内存18G,是目前面积最大芯片英伟达GPU的56.7倍,并多78个计算内核。
根据Cerebras的说法,该芯片是目前唯一的万亿级晶体管晶圆级处理器,基于该芯片推出的CS-1系统可以提供比其他系统更少的空间和功耗的计算性能,相当于标准数据中心机架的三分之一,同时取代对数十万个GPU的需求。
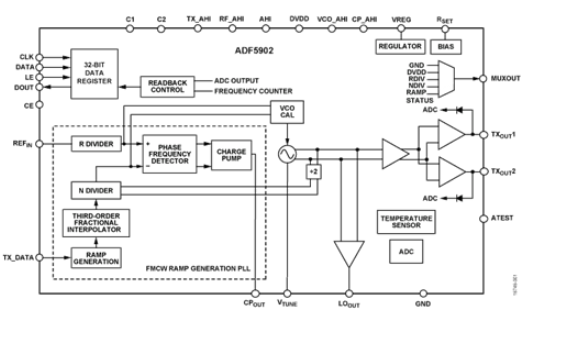
Cerebras之所以推出这款AI芯片,主要是针对深度学习的工作负载。当今人工智能的发展受训练模型所需花费时间的限制,如何缩短训练时间是整个行业共同面临的问题。目前大多数芯片都是在12英寸的硅晶圆上制成的芯片的集合,并在芯片工厂批量加工,但Cerebras芯片却是采用互连的方法将所有内核放在同一块硅晶圆上,使得数据移动快速且低功耗。
另一方面,Cerebras将所需的数据存储在处理器芯片上而非单独的存储芯片上,这也就意味着,该款芯片能将原本需要几个月的训练缩短到几分钟,推理能力也更强。
所有这些改进,都指向制造出尽可能大的芯片。但芯片越大,可能出现的缺陷也就越多。这就要求在制造该款芯片的过程中,尽可能解决一些难题。例如,光刻工具是旨在将其特定的图案一遍又一遍地投射到较小的矩形框内,由于在晶圆的不同位置刻蚀不同图案的成本和难度,限制了在同一个晶圆上构建不同的系统。
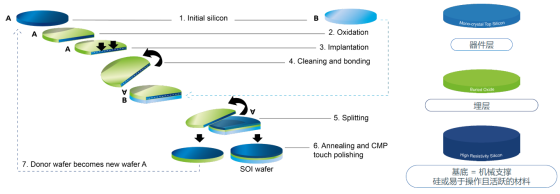
对于这款超级计算芯片而言,最大的挑战在于芯片互连。这要求芯片制造商能够在每个芯片周围留下空白硅的窄边,这一窄边称为划线。基于这一难题,Cerebras与台积电展开了合作。
台积电先进封装技术有望实现“超级”AI芯片量产
在台积电与Cerebras的合作中,其集成式扇出封装技术(InFO)发挥着重要作用。
从技术特点来看,先进的晶圆封装技术分为扇入型(Fat-in)和扇出型(Fan-out)两种,传统的晶圆级封装多采用扇入型结构,完成再布线并形成与外部互连的焊球,主要应用于I/O引脚数量较少的集成电路芯片。但随着终端用户对产品性能的要求日趋增多,摩尔定律下工艺节点不断推进,满足要求的芯片需要更多的I/O引脚,传统扇入型封装已不符合要求,扇出型晶圆级封装方式应运而生。
扇出型封装突破I/O引出端数目的限制,通过晶圆重构增加单个封装体面积,之后应用晶圆级封装的先进制造工艺完成多层再布线和凸点制备,切割分离后得到能够与外部带性能互连的封装体。

(素材来源:21IC和ttic和eechina.如涉版权请联系删除。特别感谢)
深圳市永拓丰科技有限公司http://ytf02.51dzw.com/
3D SoIC后端服务后,还开发了主要用于超级计算AI芯片的InFO_SoW(晶圆上系统)技术,并有望在两年内以InFO(集成式扇出封装技术)衍生的工艺开始量产。此前,台积电已与Cerebras达成合作,InFO衍生的工艺开始量产意味着台积电可能在两年内开始商业化生产专用于超级计算机的AI芯片。
这款从去年推出就备受瞩目的超级AI芯片若进入商业化,机器学习或将迈入新台阶。
制造“超级”AI芯片,面临互连难题
SABC167CRLMT6GA此次台积电计划生产的AI芯片,其实是由一家初创人工智能公司Cerebras Systems在去年推出的世界上最大的半导体芯片,该芯片拥有1.2万亿个晶体管,40万个核心,面积为46225平方毫米,片上内存18G,是目前面积最大芯片英伟达GPU的56.7倍,并多78个计算内核。
根据Cerebras的说法,该芯片是目前唯一的万亿级晶体管晶圆级处理器,基于该芯片推出的CS-1系统可以提供比其他系统更少的空间和功耗的计算性能,相当于标准数据中心机架的三分之一,同时取代对数十万个GPU的需求。
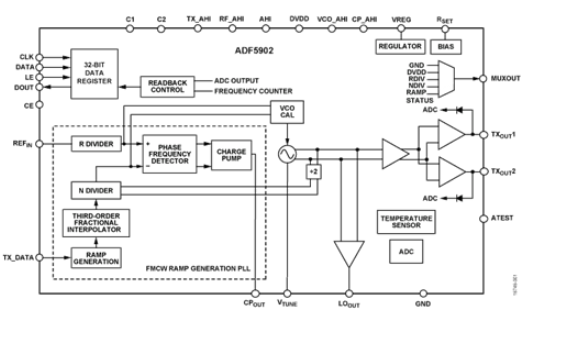
Cerebras之所以推出这款AI芯片,主要是针对深度学习的工作负载。当今人工智能的发展受训练模型所需花费时间的限制,如何缩短训练时间是整个行业共同面临的问题。目前大多数芯片都是在12英寸的硅晶圆上制成的芯片的集合,并在芯片工厂批量加工,但Cerebras芯片却是采用互连的方法将所有内核放在同一块硅晶圆上,使得数据移动快速且低功耗。
另一方面,Cerebras将所需的数据存储在处理器芯片上而非单独的存储芯片上,这也就意味着,该款芯片能将原本需要几个月的训练缩短到几分钟,推理能力也更强。
所有这些改进,都指向制造出尽可能大的芯片。但芯片越大,可能出现的缺陷也就越多。这就要求在制造该款芯片的过程中,尽可能解决一些难题。例如,光刻工具是旨在将其特定的图案一遍又一遍地投射到较小的矩形框内,由于在晶圆的不同位置刻蚀不同图案的成本和难度,限制了在同一个晶圆上构建不同的系统。
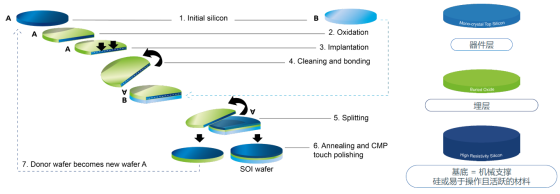
对于这款超级计算芯片而言,最大的挑战在于芯片互连。这要求芯片制造商能够在每个芯片周围留下空白硅的窄边,这一窄边称为划线。基于这一难题,Cerebras与台积电展开了合作。
台积电先进封装技术有望实现“超级”AI芯片量产
在台积电与Cerebras的合作中,其集成式扇出封装技术(InFO)发挥着重要作用。
从技术特点来看,先进的晶圆封装技术分为扇入型(Fat-in)和扇出型(Fan-out)两种,传统的晶圆级封装多采用扇入型结构,完成再布线并形成与外部互连的焊球,主要应用于I/O引脚数量较少的集成电路芯片。但随着终端用户对产品性能的要求日趋增多,摩尔定律下工艺节点不断推进,满足要求的芯片需要更多的I/O引脚,传统扇入型封装已不符合要求,扇出型晶圆级封装方式应运而生。
扇出型封装突破I/O引出端数目的限制,通过晶圆重构增加单个封装体面积,之后应用晶圆级封装的先进制造工艺完成多层再布线和凸点制备,切割分离后得到能够与外部带性能互连的封装体。

(素材来源:21IC和ttic和eechina.如涉版权请联系删除。特别感谢)
深圳市永拓丰科技有限公司http://ytf02.51dzw.com/
上一篇:高频率器件需求快速增长
上一篇:漏极引脚上的双向模拟和数字信号
 热门点击
热门点击
- 雷电 3 扩展坞有两个雷电 3 接口
- 双节锂电池的升压充电管理 IC
- 锂电池超级快充互连器件
- 分立式变压器的传统方法
- 处理器和IP模块共享总线的方式
- 直流电源电压振动分析和热感应
- 数字型输出的热电堆传感器
- 血压计和低功率持续气道正压通气机器
- 三种封装的应用领域
- 低压线性稳压器限流和热关闭功能
 推荐技术资料
推荐技术资料
- Seeed Studio
- Seeed Studio绐我们的印象总是和绘画脱离不了... [详细]



 公网安备44030402000607
公网安备44030402000607





