快速热处理工艺未来发展方向及挑战
发布时间:2017/11/10 22:35:15 访问次数:878
从表10,1我们看到,当CMOS的沟道长度降到22nm以下时,相应的PN超浅结的深度也降到F10nm以下。OP200GP虽然搭配先进的掺杂技术,如低能董高束流的大分子或原子团离子注人,以抑制主掺杂元素扩散而额外增加的非活性掺杂元素的离子注入,等离子体掺杂等,单一的毫秒级退火能形成超浅的PN结,但由于受固溶度的限制,相对应的PN结薄层电阻也会相应增加。一个可能的解决办法是用纳秒级的镭射热处理技术(LTP),它可以将晶片上局部溶化成液态,从而大大提高掺杂元素在晶格中的浓度,如图10,18所示。但这一技术还不够成熟,因为单晶硅溶化后再结晶会产生很多缺陷。另外,随着半导体器件尺寸的缩小和晶圆尺寸的增大,器件性能对热预算、对温度的敏感度越来越高。一个可以预见的挑战是,晶片及芯片层次的热均匀性、不同设计的芯片性能差别最小化越来越重要,也越来越难控制。解决这些难题,半导体设备制造厂商要想办法提高设备的性能,包括对温度侦测、温度控制的精确性、实时性,尽量消除对图形的依赖性。而芯片设计商、制造商、芯片代I厂在设计制造过程中,也可以有目的地加入一些虚拟图形以提高晶圆层面、芯片层面甚至是晶体管之间的均匀性。除此之外,在45nm以下,新的材料如源漏极外延生长的嵌人式锗硅、高介电的栅极氧化层、金属电极、Ⅲ族Ⅴ族半导体材质等,新的器件结构如FinFET、纳米管等,都会不断涌现,这就要求现有的这些热处理技术跟这些新材料之间要有好的兼容性。
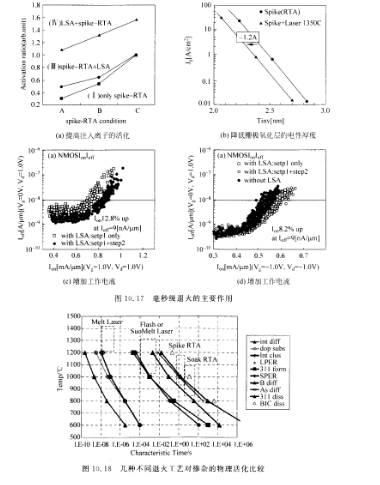
从表10,1我们看到,当CMOS的沟道长度降到22nm以下时,相应的PN超浅结的深度也降到F10nm以下。OP200GP虽然搭配先进的掺杂技术,如低能董高束流的大分子或原子团离子注人,以抑制主掺杂元素扩散而额外增加的非活性掺杂元素的离子注入,等离子体掺杂等,单一的毫秒级退火能形成超浅的PN结,但由于受固溶度的限制,相对应的PN结薄层电阻也会相应增加。一个可能的解决办法是用纳秒级的镭射热处理技术(LTP),它可以将晶片上局部溶化成液态,从而大大提高掺杂元素在晶格中的浓度,如图10,18所示。但这一技术还不够成熟,因为单晶硅溶化后再结晶会产生很多缺陷。另外,随着半导体器件尺寸的缩小和晶圆尺寸的增大,器件性能对热预算、对温度的敏感度越来越高。一个可以预见的挑战是,晶片及芯片层次的热均匀性、不同设计的芯片性能差别最小化越来越重要,也越来越难控制。解决这些难题,半导体设备制造厂商要想办法提高设备的性能,包括对温度侦测、温度控制的精确性、实时性,尽量消除对图形的依赖性。而芯片设计商、制造商、芯片代I厂在设计制造过程中,也可以有目的地加入一些虚拟图形以提高晶圆层面、芯片层面甚至是晶体管之间的均匀性。除此之外,在45nm以下,新的材料如源漏极外延生长的嵌人式锗硅、高介电的栅极氧化层、金属电极、Ⅲ族Ⅴ族半导体材质等,新的器件结构如FinFET、纳米管等,都会不断涌现,这就要求现有的这些热处理技术跟这些新材料之间要有好的兼容性。
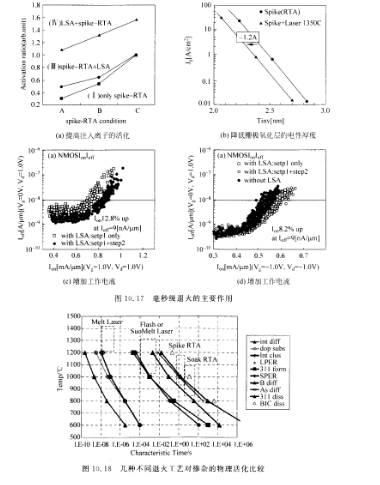



 公网安备44030402000607
公网安备44030402000607





