轮廓修正(多步沉积刻蚀)的HDP-CⅤD工艺
发布时间:2017/10/21 12:26:19 访问次数:1076
图4,18是一个典型的多步沉积亥刂蚀HDP CVD的工艺。与一般的HDP相似,主要通 K4B2G1646C-HCH9过SlH4和02反应来形成SiO2薄膜。但是沉积过程的要求与传统的HDP不同,传统的HDP CVD要求侧壁沉积尽可能薄以提供足够的开口使反应粒子可以到达沟槽底部,最大限度实现从底部到顶部的填充。但是多步DEP ETCH的HDP CVD主要是以⒏O2的刻蚀为主导的,因此轮廓结构的控制更重要,最优化的沉积应该有足够厚的侧壁保护,对称的沉积轮廓。应用材料的研究表明(见图4.19),较低的沉积温度(230~600℃)能够很大地改善侧壁的保护但又不损伤填充能力,同时可以通过调节沉积温度将薄膜的应力从180MPa调到100MPa。一旦沉积条件确定后,填充能力可以通过每个循环中沉积和刻蚀的量来优化。
降低每个沉积过程的沉积厚度可以实现更多次的轮廓调整,但是这样会增加沉积时间也引入更多的F,有可能会对器件可靠性造成影响。而沉积过程中的物理轰击气体分子量越大,可以在沟槽顶部形成Cuspil△bo来以保护沟槽顶部在刻蚀过程中不被损伤。日前主要采用He为主的He/H2混合,主要想通过保证填充能力的同时为沟槽顶部提供足够的保护。
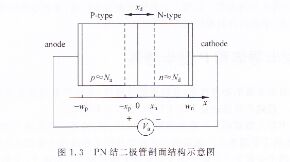
图4,18是一个典型的多步沉积亥刂蚀HDP CVD的工艺。与一般的HDP相似,主要通 K4B2G1646C-HCH9过SlH4和02反应来形成SiO2薄膜。但是沉积过程的要求与传统的HDP不同,传统的HDP CVD要求侧壁沉积尽可能薄以提供足够的开口使反应粒子可以到达沟槽底部,最大限度实现从底部到顶部的填充。但是多步DEP ETCH的HDP CVD主要是以⒏O2的刻蚀为主导的,因此轮廓结构的控制更重要,最优化的沉积应该有足够厚的侧壁保护,对称的沉积轮廓。应用材料的研究表明(见图4.19),较低的沉积温度(230~600℃)能够很大地改善侧壁的保护但又不损伤填充能力,同时可以通过调节沉积温度将薄膜的应力从180MPa调到100MPa。一旦沉积条件确定后,填充能力可以通过每个循环中沉积和刻蚀的量来优化。
降低每个沉积过程的沉积厚度可以实现更多次的轮廓调整,但是这样会增加沉积时间也引入更多的F,有可能会对器件可靠性造成影响。而沉积过程中的物理轰击气体分子量越大,可以在沟槽顶部形成Cuspil△bo来以保护沟槽顶部在刻蚀过程中不被损伤。日前主要采用He为主的He/H2混合,主要想通过保证填充能力的同时为沟槽顶部提供足够的保护。
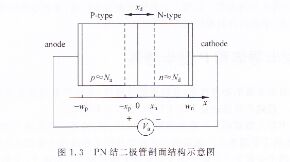
 热门点击
热门点击
- 源漏工程
- DRAM和eDRAM
- 接近式曝光的分辨率理论极限是
- 线性方程组用矩阵形式
- 无结场效应晶体管
- EUT的搭接
- 圆柱体全包围栅量子阱HEMT场效应晶体管器件
- 化学气相沉积法使用的氧源
- 轮廓修正(多步沉积刻蚀)的HDP-CⅤD工艺
- 高K栅极介质
 推荐技术资料
推荐技术资料
- Seeed Studio
- Seeed Studio绐我们的印象总是和绘画脱离不了... [详细]


 公网安备44030402000607
公网安备44030402000607





