氮氧化硅栅极氧化介电层的表征
发布时间:2017/10/18 20:47:36 访问次数:613
跟超薄⒏O2一样,当Si()N氧化介电层越来越薄时,氮氧化硅膜厚、组成成分、 NCN8664ST50T3G界面态等对器件电学性能的影响越来越重要,同时这些薄膜特性的表征也越来越困难,往往需要几种技术结合起来使用。比如说传统的偏振光椭圆率测量仪除了要求量测的光斑大小越来越小,并具有减少外部环境玷污效应(airbornc matehal contaminationeffect)的功能外,同时还需具备短波长的紫外光或远紫外光波段,以提高对氮氧化硅中化学组分的敏感度。而对透 图4射电镜来说,高分辨率(<0,2nm)的透射电镜对于观察Si02/Si或Si()N/Si的界面形貌、界面缺陷是不可或缺的。
而对于氮氧化硅介电层来说,光电子能谱(XPS)是一种比较有效的测量膜厚和组成成分的工具,它跟TEM和GV量测都有比较好的线性关系(见图4.4)「⒎田,XPS不但可用于si02或⒏ON栅极氧化介电层的厚度量测,具有角度分辨率的XPS还可以用于Si()N中氮的浓度随深度的分布测试[9]。另一种比较有效测量氮氧化硅中氮的浓度分布的工具二次离子质谱(SIMS),它可以区分不同工艺条件下制得的氮氧化硅介电层厚度、氮的浓度及分布的细微差别(见图4.5)Ll;J。对于⒏ON介电层来说,除了上述特性外,薄膜界面态、缺陷及电荷情况对介电层的电学性能的影响也至关重要。这些通常可用非接触式的GV测量仪来
实现的。非接触式GV测量设备不但可以测得超薄Si()N介电层的界面电荷,缺陷密度,还 可以表征介电层的漏电流特性[10J。以上这些测量基本上是在光片上进行的,对于一个栅极氧化介电层来说,最直接也是最重要的是当它真正用于CMOS器仵时,器件的电学性能、可靠性等,这些则需要用常规的GV、⒈V、GOI、NBTI、HCI等测量来表征[11~1侧。
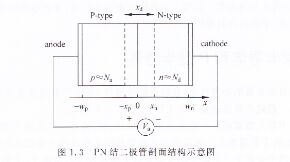
跟超薄⒏O2一样,当Si()N氧化介电层越来越薄时,氮氧化硅膜厚、组成成分、 NCN8664ST50T3G界面态等对器件电学性能的影响越来越重要,同时这些薄膜特性的表征也越来越困难,往往需要几种技术结合起来使用。比如说传统的偏振光椭圆率测量仪除了要求量测的光斑大小越来越小,并具有减少外部环境玷污效应(airbornc matehal contaminationeffect)的功能外,同时还需具备短波长的紫外光或远紫外光波段,以提高对氮氧化硅中化学组分的敏感度。而对透 图4射电镜来说,高分辨率(<0,2nm)的透射电镜对于观察Si02/Si或Si()N/Si的界面形貌、界面缺陷是不可或缺的。
而对于氮氧化硅介电层来说,光电子能谱(XPS)是一种比较有效的测量膜厚和组成成分的工具,它跟TEM和GV量测都有比较好的线性关系(见图4.4)「⒎田,XPS不但可用于si02或⒏ON栅极氧化介电层的厚度量测,具有角度分辨率的XPS还可以用于Si()N中氮的浓度随深度的分布测试[9]。另一种比较有效测量氮氧化硅中氮的浓度分布的工具二次离子质谱(SIMS),它可以区分不同工艺条件下制得的氮氧化硅介电层厚度、氮的浓度及分布的细微差别(见图4.5)Ll;J。对于⒏ON介电层来说,除了上述特性外,薄膜界面态、缺陷及电荷情况对介电层的电学性能的影响也至关重要。这些通常可用非接触式的GV测量仪来
实现的。非接触式GV测量设备不但可以测得超薄Si()N介电层的界面电荷,缺陷密度,还 可以表征介电层的漏电流特性[10J。以上这些测量基本上是在光片上进行的,对于一个栅极氧化介电层来说,最直接也是最重要的是当它真正用于CMOS器仵时,器件的电学性能、可靠性等,这些则需要用常规的GV、⒈V、GOI、NBTI、HCI等测量来表征[11~1侧。
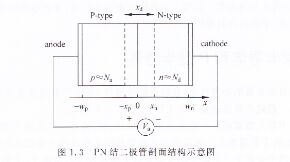
 热门点击
热门点击
- 源漏工程
- DRAM和eDRAM
- 线性方程组用矩阵形式
- 无结场效应晶体管
- EUT的搭接
- 圆柱体全包围栅量子阱HEMT场效应晶体管器件
- 化学气相沉积法使用的氧源
- 轮廓修正(多步沉积刻蚀)的HDP-CⅤD工艺
- 高K栅极介质
- 放电从人体的指尖传到器件上的导电引脚
 推荐技术资料
推荐技术资料
- Seeed Studio
- Seeed Studio绐我们的印象总是和绘画脱离不了... [详细]


 公网安备44030402000607
公网安备44030402000607





