以典型的双阱CMOS反相器为例介绍CMOS工艺流程
发布时间:2017/5/30 12:23:45 访问次数:5559
以典型的双阱CMOS反相器为例介绍CMOS工艺流程。在生产中可用n型单晶硅,PAM3101DAB180也可以用p型单晶硅作为衬底。选择不同导电类型的衬底材料,其制造工艺是不完全相同的,但原理是相同的。p型硅单晶作为衬底有两种情况:一种是直接在p型硅单晶上制造CMOS反相器,另一种用旷硅单晶为衬底,再在上面外延生长盯型硅外延层。以p/p+为衬底,主要工艺流程如图12-17~图12-19所示,其中,图12-17 所示为确定CMOS的双阱及栅结构;图12-18所示为形成nMOs和pM(B的源漏结构;图12△9所示为形成金属化系统。
(1)N阱注人
热氧化生长⒊O2缓冲层,LPCVD凯N4作为选择性热氧化目掩膜;光刻,RIE去弘N1形成n阱窗口;顺次自对准注人P离子,即n阱注人。
(2)p阱注人
去光刻胶,选择性热氧化生长⒏02作为p阱注人掩膜;同时“激活”和“驱进”P+As杂质,形成深度约6um的n阱;RIE刻蚀去s3N4,自对准注入B}离子,即p阱注人。
(3)场注人
HF腐蚀去氧化层掩膜;再热氧化生长薄涨,缓冲层,IPC、0弘N{作为选择性氧化用掩膜;光刻,RIE去凯N1形成场区窗口,去胶;自对准场注人B÷离子。
(4)pMOS阈值调整注人
热氧化形成厚的场氧化层;RIE刻蚀去弘N4;以光刻胶为掩膜进行pMOS阈值调整P+注入。
(5)nMOs阈值调整注人
去胶;光刻;以光刻胶为掩膜进行nMC)s阈值调整P+注入。
(6)栅定义
去胶,HF漂去⒏o;再干氧热氧化生长栅氧化层;LPCX/ˉD多晶硅薄膜,光刻和刻蚀形成多晶硅栅图形,去胶。
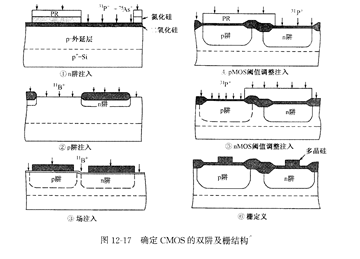
以典型的双阱CMOS反相器为例介绍CMOS工艺流程。在生产中可用n型单晶硅,PAM3101DAB180也可以用p型单晶硅作为衬底。选择不同导电类型的衬底材料,其制造工艺是不完全相同的,但原理是相同的。p型硅单晶作为衬底有两种情况:一种是直接在p型硅单晶上制造CMOS反相器,另一种用旷硅单晶为衬底,再在上面外延生长盯型硅外延层。以p/p+为衬底,主要工艺流程如图12-17~图12-19所示,其中,图12-17 所示为确定CMOS的双阱及栅结构;图12-18所示为形成nMOs和pM(B的源漏结构;图12△9所示为形成金属化系统。
(1)N阱注人
热氧化生长⒊O2缓冲层,LPCVD凯N4作为选择性热氧化目掩膜;光刻,RIE去弘N1形成n阱窗口;顺次自对准注人P离子,即n阱注人。
(2)p阱注人
去光刻胶,选择性热氧化生长⒏02作为p阱注人掩膜;同时“激活”和“驱进”P+As杂质,形成深度约6um的n阱;RIE刻蚀去s3N4,自对准注入B}离子,即p阱注人。
(3)场注人
HF腐蚀去氧化层掩膜;再热氧化生长薄涨,缓冲层,IPC、0弘N{作为选择性氧化用掩膜;光刻,RIE去凯N1形成场区窗口,去胶;自对准场注人B÷离子。
(4)pMOS阈值调整注人
热氧化形成厚的场氧化层;RIE刻蚀去弘N4;以光刻胶为掩膜进行pMOS阈值调整P+注入。
(5)nMOs阈值调整注人
去胶;光刻;以光刻胶为掩膜进行nMC)s阈值调整P+注入。
(6)栅定义
去胶,HF漂去⒏o;再干氧热氧化生长栅氧化层;LPCX/ˉD多晶硅薄膜,光刻和刻蚀形成多晶硅栅图形,去胶。
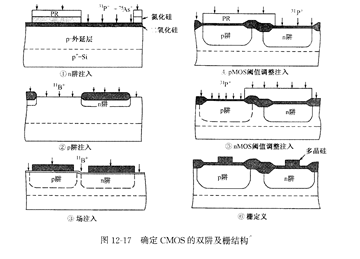
上一篇:nMOS LDD的形成



 公网安备44030402000607
公网安备44030402000607





