后光刻形成氧化物侧墙
发布时间:2017/5/30 12:16:18 访问次数:580
后光刻形成氧化物侧墙,进行源、漏区注人以形成pll结。②P`①制各50~100nm的Tl薄膜。③在氮气氛中500~600℃的温度下退火,金属Tl与硅或多晶硅接触的地方发生反应形成金属硅化物△轧,而在金属与非硅的接触区域则不会发生反应。PAM3101AAA280氮气扩散进入Ti并与之发生反应,能够在氧化层上形成稳定的TlN层,该层常用于作为扩散阻挡层。
当器件特征尺寸降到超深亚微米时,由于多晶硅栅线宽的进一步减小和源/漏结进一步变浅,加上多晶硅栅的耗尽效应和硅沟道表面层的量子效应,即使是自对准硅化物的多晶硅栅电极也不再满足要求,囚此难熔金属栅电极应运而生。它的采用不仅极大降低了多晶硅栅的电阻,而且彻底消除了多晶硅栅的耗尽效应(多晶硅栅已不存在)和硼穿透效应。已出现的金属栅有Ⅵ1/Κ栅介质的组合结构将会是下一代CMCB集成电路的首选。
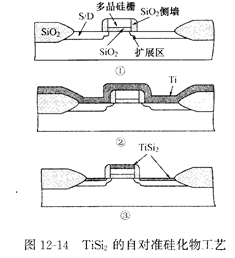
后光刻形成氧化物侧墙,进行源、漏区注人以形成pll结。②P`①制各50~100nm的Tl薄膜。③在氮气氛中500~600℃的温度下退火,金属Tl与硅或多晶硅接触的地方发生反应形成金属硅化物△轧,而在金属与非硅的接触区域则不会发生反应。PAM3101AAA280氮气扩散进入Ti并与之发生反应,能够在氧化层上形成稳定的TlN层,该层常用于作为扩散阻挡层。
当器件特征尺寸降到超深亚微米时,由于多晶硅栅线宽的进一步减小和源/漏结进一步变浅,加上多晶硅栅的耗尽效应和硅沟道表面层的量子效应,即使是自对准硅化物的多晶硅栅电极也不再满足要求,囚此难熔金属栅电极应运而生。它的采用不仅极大降低了多晶硅栅的电阻,而且彻底消除了多晶硅栅的耗尽效应(多晶硅栅已不存在)和硼穿透效应。已出现的金属栅有Ⅵ1/Κ栅介质的组合结构将会是下一代CMCB集成电路的首选。
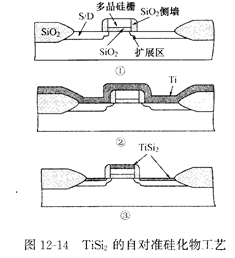
上一篇:超浅源漏延伸区结构
 热门点击
热门点击



 公网安备44030402000607
公网安备44030402000607





