提高1931m ArF浸入式光刻机NA的方案
发布时间:2017/5/27 20:24:33 访问次数:594
从光刻系统分辨率式(9△)可知,减小曝光光源的波长并增加投影透镜的NA都可以提高分辨率。 H27S2G8F2CFR-BI自从193nm波长成为主攻方向以后,增大NA成为了业界人士孜孜不倦的追求。表10乇所示是提高193nm ArF浸入式光刻机NA的方案。由此可见,浸入液、光刻设各和其他相关环节的紧密配合是浸人式光刻技术前进的保证。
表10-2 提高1931m ArF浸入式光刻机NA的方案
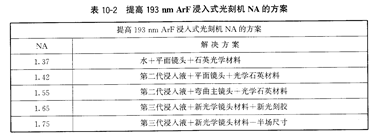
浸人式光刻技术对于全球半导体△业所带来的效益是无法估量的,可以节省大量的资金,由此对摩尔定律再能持续10~15年完全充满信心。
19311nl浸人式光刻(NA=1,35)单步曝光I艺,Kl可以缩减到0,3,能够实现32m的分辨率。而采用两次图形化工艺和分辨率增强技术,Κ1可以进一步缩小到0.15,从而使分辨率接近22nm,但是CD的控制和对准精度都因方法不同而不同。与单次曝光I艺相比,两次曝光技术会造成成本和缺陷密度的提高,对准精度容差(从∞的33%降低到CD的10%)的降低。 ’
1931lnl浸人式光刻技术应解决的技术问题是:①研发高折射率的光刻胶,⒛Or/J年光刻胶折射率为1.7;②研发高折射率的浸人液体,水折射率为1.1,研发折射率为1.6~1.7的浸人液体,折射指数大于1.65的流体满足黏度、吸收和流体循环要求;③研发高折射率的光学材料,折射指数大于1.65的透镜材料满足透镜设计的吸收和双折射要求;④控制由于浸入环境引起的缺陷,包括气泡和污染。
从光刻系统分辨率式(9△)可知,减小曝光光源的波长并增加投影透镜的NA都可以提高分辨率。 H27S2G8F2CFR-BI自从193nm波长成为主攻方向以后,增大NA成为了业界人士孜孜不倦的追求。表10乇所示是提高193nm ArF浸入式光刻机NA的方案。由此可见,浸入液、光刻设各和其他相关环节的紧密配合是浸人式光刻技术前进的保证。
表10-2 提高1931m ArF浸入式光刻机NA的方案
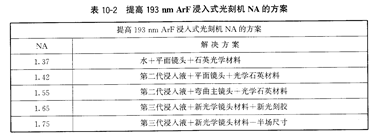
浸人式光刻技术对于全球半导体△业所带来的效益是无法估量的,可以节省大量的资金,由此对摩尔定律再能持续10~15年完全充满信心。
19311nl浸人式光刻(NA=1,35)单步曝光I艺,Kl可以缩减到0,3,能够实现32m的分辨率。而采用两次图形化工艺和分辨率增强技术,Κ1可以进一步缩小到0.15,从而使分辨率接近22nm,但是CD的控制和对准精度都因方法不同而不同。与单次曝光I艺相比,两次曝光技术会造成成本和缺陷密度的提高,对准精度容差(从∞的33%降低到CD的10%)的降低。 ’
1931lnl浸人式光刻技术应解决的技术问题是:①研发高折射率的光刻胶,⒛Or/J年光刻胶折射率为1.7;②研发高折射率的浸人液体,水折射率为1.1,研发折射率为1.6~1.7的浸人液体,折射指数大于1.65的流体满足黏度、吸收和流体循环要求;③研发高折射率的光学材料,折射指数大于1.65的透镜材料满足透镜设计的吸收和双折射要求;④控制由于浸入环境引起的缺陷,包括气泡和污染。



 公网安备44030402000607
公网安备44030402000607





