热氧化机理
发布时间:2017/5/11 22:30:41 访问次数:3178
由二氧化硅基本结构单元可知,位于四面KM29U128T体中心的s原子与4个顶角上的氧原子以共价键方式结合在一起,s原子运动要打断4个s―O键.而桥联氧原子的运动只需打断两个⒊―O键,非桥联氧原子只需打断一个s―O键。因此,在s02网络结构中,O原子比s原子更容易运动。氧原子离开其四面体位置运动后,生成氧空位。在热氧化过程中,氧离子或水分子能够在已生长的siC)2中扩散进人⒊/Si()2界面,与s原子反应生成新的SlC,2网络结构,使SlO?膜不断增厚。与此相反,硅体内的s原子则不容易挣脱s共价键的束缚,也不容易在已生长的陨冫网络中移动。所以,在热氧化的过程中,氧化反应将在s/sfl,界面处进行,而不发生在sQ层的外表层,这一特性决定了热氧化的机理。
进一步的研究指出,氧在so中的扩散是以离子形式进行的。氧进人⒊O2后便离解成氧离f(σ)。氧离子通过扩散而到达⒏/Si()?界面,然后在界面处与⒏发生反应而形成新的s02,从而使SiO2层越长越厚。同时,随着氧离子通过Sl(`层的扩散,也必将有空穴的扩散,而空穴的扩散速率比氧离子的扩散速率快,结果在s02层中产生一内建电场,此内建电场的方向正好使该电场起着加速σ^扩散的作用。不过分析指出,这种加速扩散的作用只存在于⒊C,~表面一个很薄的范围内(对干氧氧化为150~⒛0A,对水汽氧化仅为5Λ)。首先,S√Sio2界面处的一个⒏原子夺取邻近的sK、中的两个氧离子,形成一个新的sO2,相应地在界面附近的s02层中产生出两个氧离子空位,然后,SK)z层上部的氧离子又不断扩散到界面附近来填补氧离子空位,这样氧就以SiO2中的氧离子空位作为媒介而扩散到s/SK)2界面。这就说明l高温氧化过程中氧由.表面往内部的扩散,实质上也就是氧离子空位由⒊/Si02界面处不断向Si()P表面扩散的过程。总而言之,干氧氧化含有的氧离子包括通过so2的扩散和在⒏/so2界面上与硅发生化学反应这两个过程。在较高温度(例如1000°C以上)下,界面化学反应速率较快,而氧离子扩散通过so2的过程较慢,因此氧化速率将主要取决于氧离子扩散通过sC,层的快慢。显然,这时随着氧化的进行,SK)2层不断增厚,氧化速率也就越来越慢。
热氧化是通过扩散与化学反应来完成的,由于氧化实际上是在S√Si02界面进行的,氧化反应是由硅片表面向硅片纵深依次进行的,硅被消耗,所以硅片变薄,氧化层增厚是⒊02生长过程中界面位置随热氧化过程而移动的示意图。
由二氧化硅基本结构单元可知,位于四面KM29U128T体中心的s原子与4个顶角上的氧原子以共价键方式结合在一起,s原子运动要打断4个s―O键.而桥联氧原子的运动只需打断两个⒊―O键,非桥联氧原子只需打断一个s―O键。因此,在s02网络结构中,O原子比s原子更容易运动。氧原子离开其四面体位置运动后,生成氧空位。在热氧化过程中,氧离子或水分子能够在已生长的siC)2中扩散进人⒊/Si()2界面,与s原子反应生成新的SlC,2网络结构,使SlO?膜不断增厚。与此相反,硅体内的s原子则不容易挣脱s共价键的束缚,也不容易在已生长的陨冫网络中移动。所以,在热氧化的过程中,氧化反应将在s/sfl,界面处进行,而不发生在sQ层的外表层,这一特性决定了热氧化的机理。
进一步的研究指出,氧在so中的扩散是以离子形式进行的。氧进人⒊O2后便离解成氧离f(σ)。氧离子通过扩散而到达⒏/Si()?界面,然后在界面处与⒏发生反应而形成新的s02,从而使SiO2层越长越厚。同时,随着氧离子通过Sl(`层的扩散,也必将有空穴的扩散,而空穴的扩散速率比氧离子的扩散速率快,结果在s02层中产生一内建电场,此内建电场的方向正好使该电场起着加速σ^扩散的作用。不过分析指出,这种加速扩散的作用只存在于⒊C,~表面一个很薄的范围内(对干氧氧化为150~⒛0A,对水汽氧化仅为5Λ)。首先,S√Sio2界面处的一个⒏原子夺取邻近的sK、中的两个氧离子,形成一个新的sO2,相应地在界面附近的s02层中产生出两个氧离子空位,然后,SK)z层上部的氧离子又不断扩散到界面附近来填补氧离子空位,这样氧就以SiO2中的氧离子空位作为媒介而扩散到s/SK)2界面。这就说明l高温氧化过程中氧由.表面往内部的扩散,实质上也就是氧离子空位由⒊/Si02界面处不断向Si()P表面扩散的过程。总而言之,干氧氧化含有的氧离子包括通过so2的扩散和在⒏/so2界面上与硅发生化学反应这两个过程。在较高温度(例如1000°C以上)下,界面化学反应速率较快,而氧离子扩散通过so2的过程较慢,因此氧化速率将主要取决于氧离子扩散通过sC,层的快慢。显然,这时随着氧化的进行,SK)2层不断增厚,氧化速率也就越来越慢。
热氧化是通过扩散与化学反应来完成的,由于氧化实际上是在S√Si02界面进行的,氧化反应是由硅片表面向硅片纵深依次进行的,硅被消耗,所以硅片变薄,氧化层增厚是⒊02生长过程中界面位置随热氧化过程而移动的示意图。
上一篇:影响氧化速率的各种因素


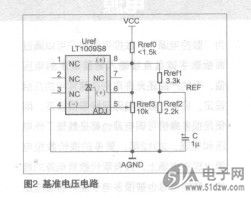
 公网安备44030402000607
公网安备44030402000607





