MOS微电子技术简介
发布时间:2008/12/3 0:00:00 访问次数:630
mos场效应晶体管是金属-氧化物-半导体场效应晶体管的简称,它通过改变外加电压产生的电场强度来控制其导电能力。mos场效应晶体管不仅具有双极型三极管体积小、重量轻、耗电少、寿命长等优点,而且还具有输入阻抗高、热稳定性好、抗辐射能力强、噪声低、制造工艺简单、便于集成等特点。因而,在大规模及超大规模集成电路中得到了广泛的应用。
与双极型三极管不同,mos晶体管是电压控制元件,参与导电的只有一种载流子,因此称其为单极型器件。mos晶体管可以分为增强型晶体管与耗尽型晶体管两种。根据沟道掺杂不同,又可分为n沟道增强型晶体管、p沟道增强型晶体管、n沟道耗尽型晶体管和p沟道耗尽型晶体管四种。图1展示了n沟道增强型和耗尽型两种晶体管的结构示意图。
图1 n沟道增强型和耗尽型晶体管结构示意图
图1中显示的g、d、s分别叫做mos晶体管的栅极、漏极和源极。从图中可以看出,增强型晶体管与耗尽型晶体管的区别在于,耗尽型晶体管存在原始导电沟道,而增强型晶体管没有原始导电沟道。
对于增强型晶体管,当ugs=0时,漏源之间相当于两个背靠背的pn结,无论dds的值大小如何都不会在d、s间形成电流id,即id=0;当ugs较小时,虽然在p型衬底表面形成一层耗尽层,但负离子不能导电;当ugs=t时,在p型衬底表面形成一层电子层,形成n型导电沟道,在uds的作用下形成。,晶体管开始导通;当ugs>ut时,沟道加厚,沟道电阻减少,在相同uds的作用下,id将进一步增加。对于耗尽型晶体管,当ugs=0时,uds加正向电压,产生漏极电流id,此时的漏极电流称为漏极饱和电流,用udss表示;当(ucs)0时,将使id进一步增加;当已ugs<0时,随着ugs的减小漏极电流逐渐减小,直至id=0,对应id=0的(ugs称为夹断电压,用符号up表示。由以上的分析可以看出,mos场效应晶体管利用栅源电压的大小,来改变半导体表面感生电荷的多少,从而控制漏极电流的大小。
将p沟道mos晶体管与n沟道mos晶体管同时运用到一个集成电路中就构成了cmos集成电路。cmos集成电路具有静态功耗低、电源电压范围宽、输出电压幅度宽、速度快、密度高等优点,已成为目前微电子工业的主流技术。
cmos集成电路用p沟道mos管作为负载器件,n沟道mos管作为驱动器件,因此在同个衬底上同时制作p沟道mos晶体管和n沟道mos晶体管。在制作中,必须将一种mos晶体管制作在衬底上,而将另一种mos晶体管制作在比衬底浓度高的阱中。cmos集成电路工艺根据阱的导电类型可以分为p阱工艺、n阱工艺和双阱工艺。本节具体介绍目前较为流行的双阱工艺的流程。图2是双阱工艺cmos器件的结构示意图。
图2 双阱工艺cmos器件的结构示意图
图3介绍了双阱工艺cmos器件的主要流程。首先,在已经清洁过的硅衬底上淀积一层二氧化硅(sio2)层。在光刻胶的保护下,将n阱区刻蚀出来,并将n型杂质注入到硅衬底中。将二氧化硅层去除,这样就形成n阱区域。用同样的步骤可以形成p阱区域。然后在需要制作晶体管隔离的区域注入隔离杂质。注入时需要在硅衬底上覆盖氧化层和氮化硅层保护其他区域。在隔离区域生长氧化物隔离层,从而实现晶体管之间的电气隔离。下一步是生长栅氧化层,并在氧化层上淀积多晶硅形成栅极。接着在光刻胶的保护下,对晶体管有源区进行注入。由于在同一衬底上需要制作两种晶体管,所以在注入时需要分开来进行。图3中还展示了衬底接触区域的注入。最后在栅极旁边制作栅极氧化保护,并在各极淀积硅化物作接触点。这样一个双阱工艺的cmos器件就制作完成了。
图3 双阱工艺cmos器件主要流程
欢迎转载,信息来自维库电子市场网(www.dzsc.com)
mos场效应晶体管是金属-氧化物-半导体场效应晶体管的简称,它通过改变外加电压产生的电场强度来控制其导电能力。mos场效应晶体管不仅具有双极型三极管体积小、重量轻、耗电少、寿命长等优点,而且还具有输入阻抗高、热稳定性好、抗辐射能力强、噪声低、制造工艺简单、便于集成等特点。因而,在大规模及超大规模集成电路中得到了广泛的应用。
与双极型三极管不同,mos晶体管是电压控制元件,参与导电的只有一种载流子,因此称其为单极型器件。mos晶体管可以分为增强型晶体管与耗尽型晶体管两种。根据沟道掺杂不同,又可分为n沟道增强型晶体管、p沟道增强型晶体管、n沟道耗尽型晶体管和p沟道耗尽型晶体管四种。图1展示了n沟道增强型和耗尽型两种晶体管的结构示意图。
图1 n沟道增强型和耗尽型晶体管结构示意图
图1中显示的g、d、s分别叫做mos晶体管的栅极、漏极和源极。从图中可以看出,增强型晶体管与耗尽型晶体管的区别在于,耗尽型晶体管存在原始导电沟道,而增强型晶体管没有原始导电沟道。
对于增强型晶体管,当ugs=0时,漏源之间相当于两个背靠背的pn结,无论dds的值大小如何都不会在d、s间形成电流id,即id=0;当ugs较小时,虽然在p型衬底表面形成一层耗尽层,但负离子不能导电;当ugs=t时,在p型衬底表面形成一层电子层,形成n型导电沟道,在uds的作用下形成。,晶体管开始导通;当ugs>ut时,沟道加厚,沟道电阻减少,在相同uds的作用下,id将进一步增加。对于耗尽型晶体管,当ugs=0时,uds加正向电压,产生漏极电流id,此时的漏极电流称为漏极饱和电流,用udss表示;当(ucs)0时,将使id进一步增加;当已ugs<0时,随着ugs的减小漏极电流逐渐减小,直至id=0,对应id=0的(ugs称为夹断电压,用符号up表示。由以上的分析可以看出,mos场效应晶体管利用栅源电压的大小,来改变半导体表面感生电荷的多少,从而控制漏极电流的大小。
将p沟道mos晶体管与n沟道mos晶体管同时运用到一个集成电路中就构成了cmos集成电路。cmos集成电路具有静态功耗低、电源电压范围宽、输出电压幅度宽、速度快、密度高等优点,已成为目前微电子工业的主流技术。
cmos集成电路用p沟道mos管作为负载器件,n沟道mos管作为驱动器件,因此在同个衬底上同时制作p沟道mos晶体管和n沟道mos晶体管。在制作中,必须将一种mos晶体管制作在衬底上,而将另一种mos晶体管制作在比衬底浓度高的阱中。cmos集成电路工艺根据阱的导电类型可以分为p阱工艺、n阱工艺和双阱工艺。本节具体介绍目前较为流行的双阱工艺的流程。图2是双阱工艺cmos器件的结构示意图。
图2 双阱工艺cmos器件的结构示意图
图3介绍了双阱工艺cmos器件的主要流程。首先,在已经清洁过的硅衬底上淀积一层二氧化硅(sio2)层。在光刻胶的保护下,将n阱区刻蚀出来,并将n型杂质注入到硅衬底中。将二氧化硅层去除,这样就形成n阱区域。用同样的步骤可以形成p阱区域。然后在需要制作晶体管隔离的区域注入隔离杂质。注入时需要在硅衬底上覆盖氧化层和氮化硅层保护其他区域。在隔离区域生长氧化物隔离层,从而实现晶体管之间的电气隔离。下一步是生长栅氧化层,并在氧化层上淀积多晶硅形成栅极。接着在光刻胶的保护下,对晶体管有源区进行注入。由于在同一衬底上需要制作两种晶体管,所以在注入时需要分开来进行。图3中还展示了衬底接触区域的注入。最后在栅极旁边制作栅极氧化保护,并在各极淀积硅化物作接触点。这样一个双阱工艺的cmos器件就制作完成了。
图3 双阱工艺cmos器件主要流程
欢迎转载,信息来自维库电子市场网(www.dzsc.com)
上一篇:Bi-CMOS微电子技术简介
上一篇:双极型微电子技术简介



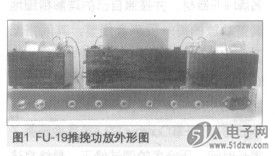
 公网安备44030402000607
公网安备44030402000607





