RIB刻蚀气体系统
发布时间:2008/12/3 0:00:00 访问次数:651
rib中一般不采用单一品种的气体,而是数种气体的组合(气体系统)。其作用分别是:
(1)主刻蚀气体。一般用含卤族元素的气体,特别是卤碳化合物气体。之所以较少使用纯卤元素气体,是因为其化合物气体较易处理,操作危险性小。
(2)惰性气体(ar,he等)起稳定和均匀等离子体的作用,并有加强各向异性刻蚀效果的作用。
(3)基团或未饱和物的清除物。在电子轰击下,有一部分卤碳化合物被分解成卤素(刻蚀剂)和不饱和卤碳化合物(卤素被剥离后剩下的部分)。不饱和卤碳化合物可能是刻蚀剂,也可能不是。它可与卤素重新复合(这会降低刻蚀剂卤素的浓度),也可能形成聚合物(polymers)(聚合物有可能阻止刻蚀进行,但如落到侧壁(sidewall)上,可以作为掩膜保护图形侧壁,有利于各向异性刻蚀)。实用上常用氧化性气体(02)或还原性气体(h2)的添加。通过上述机制,达到改善选择性及各向异性的目的。例如,在纯cf4等离子体中刻s1/si02。刻蚀速率及选择性都很低。因为等离子体分解了cf4→f十cfx(x≤3)后,f与cfx又不断地复合。因此/的稳态浓度很低,刻蚀速率很低。加入02后,02与cf.反应形成cof2、co、co2,减少了f原子的复合损耗。
结果:
①f原子浓度增加,51刻蚀速率因而增加。
②减少cf,形成polymers的趋向;另一方面,02又会吸附到si表面形成sio,,影响到与sio2的选择比。而加入h2后,h与f结合,形成hf,使si刻蚀速率下降。而cf,增加,使si02刻蚀速率增加。
(4)天然氧化物清除剂。有些材料(如a1、si)容易氧化,其天然氧化物膜的存在,妨碍刻蚀的启动。如刻51时,添加c2f6;刻a1时添加bc13。这样可以清除天然氧化层,进而启动刻蚀进程。
欢迎转载,信息来自维库电子市场网(www.dzsc.com)
rib中一般不采用单一品种的气体,而是数种气体的组合(气体系统)。其作用分别是:
(1)主刻蚀气体。一般用含卤族元素的气体,特别是卤碳化合物气体。之所以较少使用纯卤元素气体,是因为其化合物气体较易处理,操作危险性小。
(2)惰性气体(ar,he等)起稳定和均匀等离子体的作用,并有加强各向异性刻蚀效果的作用。
(3)基团或未饱和物的清除物。在电子轰击下,有一部分卤碳化合物被分解成卤素(刻蚀剂)和不饱和卤碳化合物(卤素被剥离后剩下的部分)。不饱和卤碳化合物可能是刻蚀剂,也可能不是。它可与卤素重新复合(这会降低刻蚀剂卤素的浓度),也可能形成聚合物(polymers)(聚合物有可能阻止刻蚀进行,但如落到侧壁(sidewall)上,可以作为掩膜保护图形侧壁,有利于各向异性刻蚀)。实用上常用氧化性气体(02)或还原性气体(h2)的添加。通过上述机制,达到改善选择性及各向异性的目的。例如,在纯cf4等离子体中刻s1/si02。刻蚀速率及选择性都很低。因为等离子体分解了cf4→f十cfx(x≤3)后,f与cfx又不断地复合。因此/的稳态浓度很低,刻蚀速率很低。加入02后,02与cf.反应形成cof2、co、co2,减少了f原子的复合损耗。
结果:
①f原子浓度增加,51刻蚀速率因而增加。
②减少cf,形成polymers的趋向;另一方面,02又会吸附到si表面形成sio,,影响到与sio2的选择比。而加入h2后,h与f结合,形成hf,使si刻蚀速率下降。而cf,增加,使si02刻蚀速率增加。
(4)天然氧化物清除剂。有些材料(如a1、si)容易氧化,其天然氧化物膜的存在,妨碍刻蚀的启动。如刻51时,添加c2f6;刻a1时添加bc13。这样可以清除天然氧化层,进而启动刻蚀进程。
欢迎转载,信息来自维库电子市场网(www.dzsc.com)
上一篇:RIE的质量控制指标
上一篇:微电子工艺氧化


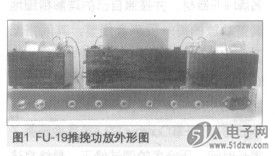
 公网安备44030402000607
公网安备44030402000607





