回流焊和波峰焊时变形
发布时间:2020/8/4 22:34:03 访问次数:1632
DSP-21161NKCAZ100的数据表,它是属于集成电路(IC) 嵌入式 - DSP(数字式信号处理器)。 具体规格参数如下:包装:托盘;系列:SHARC®;类型:浮点;接口:主机接口,连接端口,串行端口;时钟速率:100MHz;
厂商:亚德诺半导体类别: 集成电路(IC)/嵌入式 - DSP(数字式信号处理器)/主要规格参数: 包装:托盘系列:SHARC®类型:浮点接口:主机接口,连接端口,串行端口时钟速率:100MHz非易失性存储器:外部片载RAM:128kB电压-I/O:3.30V电压-内核:1.80V工作温度:0°C ~ 85°C安装类型:表面贴装封装/外壳:225-BGA,CSPBGA供应商器件封装:225-CSPBGA(17x17)
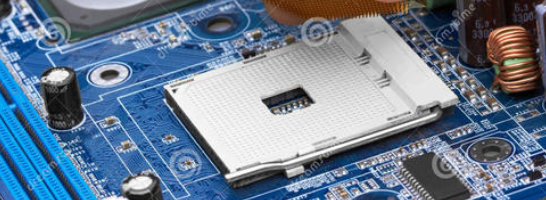
分析PCBA拼板有以下几点要求:
PCBA板的尺寸不可以太大,也不可以太小,以生产、测试、装配工程中便于生产设备的加工和不产生较大的变形为宜。现在生产使用的PCB大部分都使用纸质和复合环氧树脂基板在拼板过大的情况下很容易产生变形,所以要充份考虑拼板的大小问题。
PCBA基板过大,或拼板过大要充分考虑板材的选用,防止在回流焊和波峰焊时变形超过标准要求。
PCBA拼板的大小应充分考虑到生产设备的局限性,目前的生产设备能适用的最大尺寸为250mm*330mm,最小尺寸为50*50(对于此类尺寸要求尽量以拼板方式设计以提升效率,需要进行AI工艺的产品PCB板如果采用拼板方式,尺寸不能大于480*160mmd、 每块板上应设计有基准标记,让机器将每块PCBA拼板当作单板看待,提高smt贴片加工和自动插件DIP精度。
PCBA拼板可采用邮孔技术或双面对刻V形槽的分割技术,在采用邮孔时,应注意搭边应均匀分布在每块拼板的四周,以避免焊接时由于PCB板受力不均匀而导致变形。邮孔的位置应靠近PCB板内侧,防止拼板分离后邮****孔处残留的毛刺影响客户的整机装配。采用双面V形槽时,V形槽的深度应控制在1/3左右,要求刻槽尺寸精确,深度均匀。
PCBA设计双面贴装元器件不进行波峰焊接的PCB板时,可采用双数拼板正反面各半,两面图形按相同的排列方式可提高设备的利用率,节约生产设备费用和时间。

这种极端走势背后代表着产业趋势的此消彼长,代表着一个产业的命运,不仅是intel和AMD如此,中芯和华为也同样如此。1财报对intel意味着什么?intel这份财报,读到第4页就可以扔了,核心是对7nm制程的发言:
intel的IDM模式(设计、制造、封装一体)在和AMD+台积电(分别代表设计fabless+制造foundry) 这种垂直分工模式的竞争中,英特尔在关键的先进制程方面,很难再往前进步了。
以前intel在IDM模式下制程带来的优势,在7nm节点被卡住之后,英特尔几十年的战略优势,反而会慢慢变成劣势,每次制程升级,都要从设计、制造、封测一起升级。这次英特尔很难在制程上重新赶上来,制程越高,研发和设备成本都是翻倍增长,没有足够营收的增长支撑,根本不可能支撑intel的先进制程研发支出。
intel从顶峰往下走的预期,有分析师直言“这意味着英特尔放弃了五十年来的主要竞争优势,意味着英特尔在计算机产业统治地位的终结。
之后无论是intel继续投入IDM,还是调整战略转向fabless,但中间的调整适应期至少2-3年,而且可以预期两边都会走的尴尬。2代表的行业逻辑是什么?现在的情况是,intel没法快速跟上7nm芯片,这意味现在美国自己暂时没法本土生产7nm,之后投入资金需求更大的5nm、3nm制程,按intel现在的IDM模式发展速度,会在制造方面会完全落后于三星和台积电,也对应着美国IC设计公司对新进制程需求将更多依赖于海外供应商。
其实这一波科技浪潮中,对最先进制程的需求迫切起来,主要是由智能手机推动,尤其是以iphone为首的苹果,安卓系的高通SoC,再到华为,三星这些终端厂(自研芯片),都在砸钱去研发更先进的制程,以TSMC为首的头部晶圆厂在先进制程方面一路狂突猛进。

(素材来源:21IC.如涉版权请联系删除。特别感谢)
DSP-21161NKCAZ100的数据表,它是属于集成电路(IC) 嵌入式 - DSP(数字式信号处理器)。 具体规格参数如下:包装:托盘;系列:SHARC®;类型:浮点;接口:主机接口,连接端口,串行端口;时钟速率:100MHz;
厂商:亚德诺半导体类别: 集成电路(IC)/嵌入式 - DSP(数字式信号处理器)/主要规格参数: 包装:托盘系列:SHARC®类型:浮点接口:主机接口,连接端口,串行端口时钟速率:100MHz非易失性存储器:外部片载RAM:128kB电压-I/O:3.30V电压-内核:1.80V工作温度:0°C ~ 85°C安装类型:表面贴装封装/外壳:225-BGA,CSPBGA供应商器件封装:225-CSPBGA(17x17)
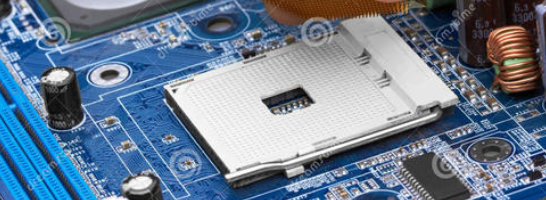
分析PCBA拼板有以下几点要求:
PCBA板的尺寸不可以太大,也不可以太小,以生产、测试、装配工程中便于生产设备的加工和不产生较大的变形为宜。现在生产使用的PCB大部分都使用纸质和复合环氧树脂基板在拼板过大的情况下很容易产生变形,所以要充份考虑拼板的大小问题。
PCBA基板过大,或拼板过大要充分考虑板材的选用,防止在回流焊和波峰焊时变形超过标准要求。
PCBA拼板的大小应充分考虑到生产设备的局限性,目前的生产设备能适用的最大尺寸为250mm*330mm,最小尺寸为50*50(对于此类尺寸要求尽量以拼板方式设计以提升效率,需要进行AI工艺的产品PCB板如果采用拼板方式,尺寸不能大于480*160mmd、 每块板上应设计有基准标记,让机器将每块PCBA拼板当作单板看待,提高smt贴片加工和自动插件DIP精度。
PCBA拼板可采用邮孔技术或双面对刻V形槽的分割技术,在采用邮孔时,应注意搭边应均匀分布在每块拼板的四周,以避免焊接时由于PCB板受力不均匀而导致变形。邮孔的位置应靠近PCB板内侧,防止拼板分离后邮****孔处残留的毛刺影响客户的整机装配。采用双面V形槽时,V形槽的深度应控制在1/3左右,要求刻槽尺寸精确,深度均匀。
PCBA设计双面贴装元器件不进行波峰焊接的PCB板时,可采用双数拼板正反面各半,两面图形按相同的排列方式可提高设备的利用率,节约生产设备费用和时间。

这种极端走势背后代表着产业趋势的此消彼长,代表着一个产业的命运,不仅是intel和AMD如此,中芯和华为也同样如此。1财报对intel意味着什么?intel这份财报,读到第4页就可以扔了,核心是对7nm制程的发言:
intel的IDM模式(设计、制造、封装一体)在和AMD+台积电(分别代表设计fabless+制造foundry) 这种垂直分工模式的竞争中,英特尔在关键的先进制程方面,很难再往前进步了。
以前intel在IDM模式下制程带来的优势,在7nm节点被卡住之后,英特尔几十年的战略优势,反而会慢慢变成劣势,每次制程升级,都要从设计、制造、封测一起升级。这次英特尔很难在制程上重新赶上来,制程越高,研发和设备成本都是翻倍增长,没有足够营收的增长支撑,根本不可能支撑intel的先进制程研发支出。
intel从顶峰往下走的预期,有分析师直言“这意味着英特尔放弃了五十年来的主要竞争优势,意味着英特尔在计算机产业统治地位的终结。
之后无论是intel继续投入IDM,还是调整战略转向fabless,但中间的调整适应期至少2-3年,而且可以预期两边都会走的尴尬。2代表的行业逻辑是什么?现在的情况是,intel没法快速跟上7nm芯片,这意味现在美国自己暂时没法本土生产7nm,之后投入资金需求更大的5nm、3nm制程,按intel现在的IDM模式发展速度,会在制造方面会完全落后于三星和台积电,也对应着美国IC设计公司对新进制程需求将更多依赖于海外供应商。
其实这一波科技浪潮中,对最先进制程的需求迫切起来,主要是由智能手机推动,尤其是以iphone为首的苹果,安卓系的高通SoC,再到华为,三星这些终端厂(自研芯片),都在砸钱去研发更先进的制程,以TSMC为首的头部晶圆厂在先进制程方面一路狂突猛进。

(素材来源:21IC.如涉版权请联系删除。特别感谢)
上一篇:脉冲或激光脉冲快速传输
上一篇:惯性传感器微机械陀螺仪
 热门点击
热门点击
- 输出额定值的多相位变压器解决方案
- 模拟电子技术的真随机数发生器
- 各行业加速推动数字化转型落地
- 两极磁铁电压进行上下裕量调节
- 测量电容器两端的电压
- 串行数据总线的全双工发送和接收
- 二级反相器与石英晶体组成多谐振荡器
- 电池组进行充电和平衡处理
- 低压变频器鼠笼式异步电动机
- 固定增益模块的可变衰减器
 推荐技术资料
推荐技术资料
- 硬盘式MP3播放器终级改
- 一次偶然的机会我结识了NE0 2511,那是一个远方的... [详细]


 公网安备44030402000607
公网安备44030402000607





