一个典型的应力临近技术工艺流程如下
发布时间:2017/10/22 11:15:14 访问次数:628
形成后去除,然后沉积双极应力刻蚀阻挡薄膜。这样就可以
最小化上面所提及的潜在问题。一个典型的应力临近技术工艺流程如下: TC74HC10AFN
(1)包括自对准硅化物形成在内的前续工艺。
(2)通过干法刻蚀来部分去除侧墙。
(3)沉积拉应力薄膜。
(4)去除PM(B区的拉应力薄膜。
(5)沉积压应力薄膜。
(6)去除NMOS区的压应力薄膜。
(7)包含沉积金属前介电薄膜在内的后续I艺。
在部分去除侧墙工艺的过程中,需要小心处理并且防止过量损失自对准硅化物。从图5.16中可以看到,采用应力临近技术进一步地提高了器件的驱动电流。
图5.16 有和没有应力临近技术的pMOs驱动电流比较
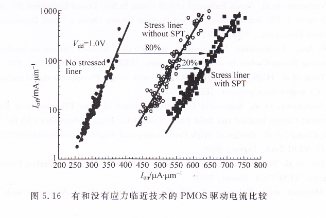
形成后去除,然后沉积双极应力刻蚀阻挡薄膜。这样就可以
最小化上面所提及的潜在问题。一个典型的应力临近技术工艺流程如下: TC74HC10AFN
(1)包括自对准硅化物形成在内的前续工艺。
(2)通过干法刻蚀来部分去除侧墙。
(3)沉积拉应力薄膜。
(4)去除PM(B区的拉应力薄膜。
(5)沉积压应力薄膜。
(6)去除NMOS区的压应力薄膜。
(7)包含沉积金属前介电薄膜在内的后续I艺。
在部分去除侧墙工艺的过程中,需要小心处理并且防止过量损失自对准硅化物。从图5.16中可以看到,采用应力临近技术进一步地提高了器件的驱动电流。
图5.16 有和没有应力临近技术的pMOs驱动电流比较
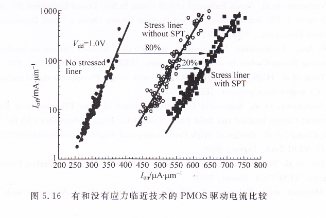
上一篇:在源/漏区选择性外延生长锗化硅。
上一篇:金属栅极的使用
 热门点击
热门点击
- 编制工艺文件的原则与要求
- 普通晶闸管是由四层半导体材料组成的
- HDP-CVD工艺重要参数-沉积刻蚀比
- 在PNL的基础上叉有两个改进工艺LRW(lo
- 影响对焦深度的因素主要有几点
- 增大晶圆的尺寸
- 消除光刻胶底部的反射光一般采用底部抗反射层
- 空心圆柱体类别选择Tube
- 尽量避免在低频模拟信号电路的PCB中使用大面
- 若时间继电器常开延时闭合触点正常
 推荐技术资料
推荐技术资料
- 硬盘式MP3播放器终级改
- 一次偶然的机会我结识了NE0 2511,那是一个远方的... [详细]


 公网安备44030402000607
公网安备44030402000607





