衬底中运动的电子与硅原子间的碰撞减少
发布时间:2016/5/2 18:11:57 访问次数:757
首先,考虑温度的问题,大多数RFRXD0420-I/LQ可靠性试验证明,环境温度越高,器件退化越严重。而热载流子的情况则相反,温度越低,热载流子效应越明显。研究显示在-40℃时比室温下退化更为严重。热载流子在低温下的加速可这样来解释:低温下,Si原子的振动变弱,衬底中运动的电子与硅原子间的碰撞减少,电子的自由程增加,从电场中获得的能量增加,容易产生热电子,提高了注入氧化层的概率。另外也容易发生电离碰撞,产生二次电子,这些二次电子也可成为热电子,使注入氧化层中的热电子进一步增多,这就导致低温下热电子效应的加速。
其次,为防止外界水分、杂质等的侵入,芯片外一般加有保护的钝化膜。钝化层原来采用磷硅玻璃,后来采用等离子体氮化硅膜。这种膜中含有氢,氢的原子半径很小,极易扩散进入栅下Si-Si0。界面处,取代氧与硅形成Si-H、Si-OH键,热载流子的注入使Si-H、Si-OH键破坏,在氧化层中形成Q,。或Q。。,从而使热载流子效应严重。针对这一问题,可用化学气相沉积的氮化硅膜保护栅极区来防止氢原子扩散进入。
一些研究证明,工作在交流条件下器件热载流子的退化比直流条件下更严重。
改进措施
漏极附近电场强度的增加是引发沟道热载流子效应的原因,因此,要减轻漏极附近的场强,比较有效的措施是采用轻掺杂源一漏(Lightly Doped Drain-Source,LDDS)结构,使雪崩注入区向硅衬底下移,离开栅界面处。
对深亚微米器件,还可采用P-I-N漏MOSFET结构来抑制热载流子效应,所谓P-I-N漏结构是在常规沟道区的源一漏端赴降低掺杂浓度至接近本征的lois/cn3~l016/Cm3(N沟道仍为P区),可进一步降低近漏端电场强度。
首先,考虑温度的问题,大多数RFRXD0420-I/LQ可靠性试验证明,环境温度越高,器件退化越严重。而热载流子的情况则相反,温度越低,热载流子效应越明显。研究显示在-40℃时比室温下退化更为严重。热载流子在低温下的加速可这样来解释:低温下,Si原子的振动变弱,衬底中运动的电子与硅原子间的碰撞减少,电子的自由程增加,从电场中获得的能量增加,容易产生热电子,提高了注入氧化层的概率。另外也容易发生电离碰撞,产生二次电子,这些二次电子也可成为热电子,使注入氧化层中的热电子进一步增多,这就导致低温下热电子效应的加速。
其次,为防止外界水分、杂质等的侵入,芯片外一般加有保护的钝化膜。钝化层原来采用磷硅玻璃,后来采用等离子体氮化硅膜。这种膜中含有氢,氢的原子半径很小,极易扩散进入栅下Si-Si0。界面处,取代氧与硅形成Si-H、Si-OH键,热载流子的注入使Si-H、Si-OH键破坏,在氧化层中形成Q,。或Q。。,从而使热载流子效应严重。针对这一问题,可用化学气相沉积的氮化硅膜保护栅极区来防止氢原子扩散进入。
一些研究证明,工作在交流条件下器件热载流子的退化比直流条件下更严重。
改进措施
漏极附近电场强度的增加是引发沟道热载流子效应的原因,因此,要减轻漏极附近的场强,比较有效的措施是采用轻掺杂源一漏(Lightly Doped Drain-Source,LDDS)结构,使雪崩注入区向硅衬底下移,离开栅界面处。
对深亚微米器件,还可采用P-I-N漏MOSFET结构来抑制热载流子效应,所谓P-I-N漏结构是在常规沟道区的源一漏端赴降低掺杂浓度至接近本征的lois/cn3~l016/Cm3(N沟道仍为P区),可进一步降低近漏端电场强度。
 热门点击
热门点击
- system settings
- 菲涅耳半波带法
- 进行转矩补偿就是修改变频器的基本U/f线
- Pulse激励源
- Schematic Capture系统参数设
- 检偏器的透射光强
- Edit菜单
- 电子元器件是构成电子系统或电子设备的最小单元
- 改变电阻编号字体的大小
- 衬底中运动的电子与硅原子间的碰撞减少
 推荐技术资料
推荐技术资料
- 自制经典的1875功放
- 平时我也经常逛一些音响DIY论坛,发现有很多人喜欢LM... [详细]

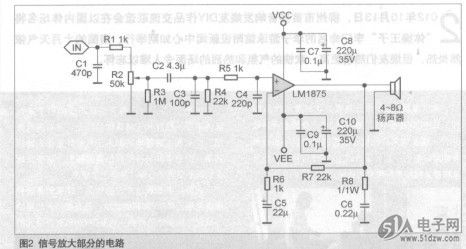
 公网安备44030402000607
公网安备44030402000607





