焊要求有两个焊点
发布时间:2015/11/15 14:24:29 访问次数:1051
焊要求有两个焊点,并且是TMS320F240PQA一个接一个进行的。要增加更多的连接数量(管脚数)。为r解决这螳问题,人们提出r用淀积在每个压焊点上的金属凸点( bump)来替代金属线。凸点也称为球( ball),与用在凸点或倒装工艺的管壳命名样为球栅阵列( BGA)。这种压焊方法允许芯片设计将压点放置在芯片的边缘和芯片的内部(见图18. 23)。这些位置将凸点放得更接近芯片电路,增加信号传送速度。把芯片翻转过来后对金属凸点的焊接实现r封装体的电
路连接。,将芯片翻转并使凸点与封装体或印制或许最大的问题来自于操作更大的电路需电路板L相应的内引脚焊接,实现与封装体的连接(见图18.24)。IBM公司称这项技术为“受控贴片连接”(C4)一。
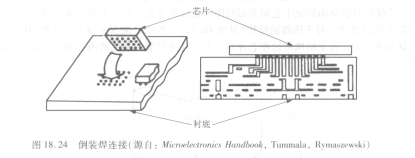
这种【艺让芯片悬在管壳表面的上方。物理应力和应变被软焊料凸点吸收。通过用环氧树脂填充缝隙可以增加应力裕度,这种填充称为下填料(underfill】凸点连接技术,起始于晶圆制造艺。
芯片倒装连接技术在晶圆制造工艺中开始,通过常用的金属化、钝化和压点图形化工艺加【晶圆。对于多芯片封装,为了加热芯片要求对其进行减薄。对于三维封装的晶圆典型地要减薄到75 ym的厚度6:。
用几种工艺流程在压点上形成焊料凸点。下面介绍的是一个工艺的例子。
焊要求有两个焊点,并且是TMS320F240PQA一个接一个进行的。要增加更多的连接数量(管脚数)。为r解决这螳问题,人们提出r用淀积在每个压焊点上的金属凸点( bump)来替代金属线。凸点也称为球( ball),与用在凸点或倒装工艺的管壳命名样为球栅阵列( BGA)。这种压焊方法允许芯片设计将压点放置在芯片的边缘和芯片的内部(见图18. 23)。这些位置将凸点放得更接近芯片电路,增加信号传送速度。把芯片翻转过来后对金属凸点的焊接实现r封装体的电
路连接。,将芯片翻转并使凸点与封装体或印制或许最大的问题来自于操作更大的电路需电路板L相应的内引脚焊接,实现与封装体的连接(见图18.24)。IBM公司称这项技术为“受控贴片连接”(C4)一。
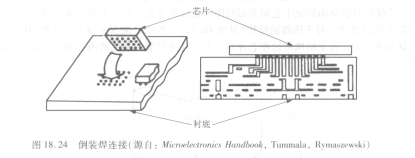
这种【艺让芯片悬在管壳表面的上方。物理应力和应变被软焊料凸点吸收。通过用环氧树脂填充缝隙可以增加应力裕度,这种填充称为下填料(underfill】凸点连接技术,起始于晶圆制造艺。
芯片倒装连接技术在晶圆制造工艺中开始,通过常用的金属化、钝化和压点图形化工艺加【晶圆。对于多芯片封装,为了加热芯片要求对其进行减薄。对于三维封装的晶圆典型地要减薄到75 ym的厚度6:。
用几种工艺流程在压点上形成焊料凸点。下面介绍的是一个工艺的例子。
上一篇:铝线压焊法
上一篇:溅射淀积内部金属堆叠



 公网安备44030402000607
公网安备44030402000607





