多晶硅和非晶硅淀积
发布时间:2015/11/8 18:18:19 访问次数:1100
直到20世纪70年代中期,硅栅MOS器件的出现(见图12. 37), HCPL-0723多晶硅才在器件结构中得以应用。硅一栅器件技术加速了淀积多晶硅薄膜的可靠工艺的需求。到20世纪80年代,多晶硅似乎成r先进器件材料的主力军。除了MOS栅之外,多晶硅还用在SRAM器件中的负载电阻、沟槽填充;EEPROM中的多层聚合物、接触阻隔层;双极型器件的发射极和硅化物金属配置中的一部分(见第13章和第16章)。
早期的T艺仅涉及将覆盖有氧化物的晶圆放在水平式APCVD系统中,并在氧化物上淀积多晶硅。多晶硅的淀积和外延淀积的主要区别是硅烷( Silane)的使用,、硅烷没有受到外延膜淀积的青睐,而在多晶硅淀积中得到r广泛的应用。
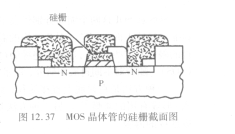
典型的多晶硅淀积工艺的温度在600℃~ 650℃范围,,淀积可能来自100%的硅烷或含有N:或H:的气体。多晶硅的结构在前面描述过,如硅原子在整体上的无序排列。在淀积多晶硅时,结构有些不同。在淀积的起始阶段,温度在575℃下,结构是非晶态的。淀积工艺形成的多晶结构由单晶硅的小核(晶体或晶核)组成。单晶硅被晶核的边界分隔。这种结构称为柱形多晶( columnar poly)。
直到20世纪70年代中期,硅栅MOS器件的出现(见图12. 37), HCPL-0723多晶硅才在器件结构中得以应用。硅一栅器件技术加速了淀积多晶硅薄膜的可靠工艺的需求。到20世纪80年代,多晶硅似乎成r先进器件材料的主力军。除了MOS栅之外,多晶硅还用在SRAM器件中的负载电阻、沟槽填充;EEPROM中的多层聚合物、接触阻隔层;双极型器件的发射极和硅化物金属配置中的一部分(见第13章和第16章)。
早期的T艺仅涉及将覆盖有氧化物的晶圆放在水平式APCVD系统中,并在氧化物上淀积多晶硅。多晶硅的淀积和外延淀积的主要区别是硅烷( Silane)的使用,、硅烷没有受到外延膜淀积的青睐,而在多晶硅淀积中得到r广泛的应用。
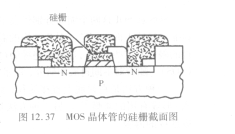
典型的多晶硅淀积工艺的温度在600℃~ 650℃范围,,淀积可能来自100%的硅烷或含有N:或H:的气体。多晶硅的结构在前面描述过,如硅原子在整体上的无序排列。在淀积多晶硅时,结构有些不同。在淀积的起始阶段,温度在575℃下,结构是非晶态的。淀积工艺形成的多晶结构由单晶硅的小核(晶体或晶核)组成。单晶硅被晶核的边界分隔。这种结构称为柱形多晶( columnar poly)。
上一篇:CMOS外延
 热门点击
热门点击
- 电容一电压曲线
- 双大马士革工艺
- 溅射工艺的原理
- 步进式光刻机
- 离子束刻蚀
- 管、盒跨接地线
- 电力电缆接头的布置应符合下列要求
- 干氧氧化( dryox)
- 半导体材料的独特性质之一
- 选择性是等离子体刻蚀工艺的一个主要的考虑事项
 推荐技术资料
推荐技术资料
- 泰克新发布的DSA830
- 泰克新发布的DSA8300在一台仪器中同时实现时域和频域分析,DS... [详细]


 公网安备44030402000607
公网安备44030402000607





