3D组装技术
发布时间:2011/8/25 10:48:33 访问次数:1213
1.什么是3D组装技术 BCM4501KQME33G
在实现电子产品特别是移动产品微型化和多功能化的众多措施中,最有效的措施除了元嚣件电路高集成化和封装微小型化外,就是组装结构的立体化,即通常所说的3D组装技术。3D组装又称为立体或三维组装技术,是相对于平面组装而言的组装设计和工艺技术,在电子组装中早有应用,只不过近年由于产品微小型化要求越来越高而显得更为重要,并且在电子制造技术的快速发展和进步中有了新的发展。
3D组装技术主要有板级元器件3D组装和整机3D组装两个层级,这里只介绍板级元器件3D组装,整机3D组装将在后面章节介绍。
2.板级元器件3D组装
板级元器件3D组装就是在PCB上将元器件在Z方向堆叠安装,也称为PoP(package on package)或立体组装。早期的PoP采用标准周边引脚封装直接堆叠(见图5.5.16),随着IC封装技术的发展,BGA等面部引线封装应用越来越多,PoP也发展到面部引线封装的堆叠(见图5.5.17),这些封装的内部也可以是芯片内3D封装PiP(package in package),从而达到更高密度的电路结构。这种用于3D组装的封装是按照3D组装的要求封装的,例如图5.5.17中下面的BGA除了底部的焊球阵列外,封装上面还要制作焊盘以实现与上面BGA的互连组装。
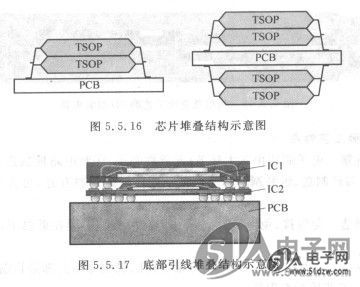
目前,板级元器件3D纽装已日益广泛地应用于数码相机、通信设备、手机等电子产品中,采用3D组装的比例逐年增加。板级立体组装在实现更好的电子学性能,提高空间利用率的同时也面临着更多复杂的设计和装配工艺技术的挑战。芯片堆叠要求更高的贴片和焊接精度及成熟的助焊剂工艺能力,抗干扰和热管理等技术也亟待进一步突破。在底部组装形式中,由于芯片与阻容器件之间的距离不到0.1mm,在焊接过程中热量在芯片和阻容器件间分布不均匀,为了实现芯片及其下部阻容器件的立体组装,需要对组装的总体流程方案进行设计,掌握焊盘设计技术、模板设计技术及阶梯焊接技术等。 D6406AID
板级元器件3D组装的优点:
①装配前各个器件可进行单独测试,从而保障了更高的良品率;
②可组合不同供应商的器件;
③总的堆叠制造成本可降至最低。
板级元器件3D组装的缺点:
①组装技术难度提高,要求更复杂的装配工艺和性能更高的设备;
②较高的装配外廓;
③检测困难。
1.什么是3D组装技术 BCM4501KQME33G
在实现电子产品特别是移动产品微型化和多功能化的众多措施中,最有效的措施除了元嚣件电路高集成化和封装微小型化外,就是组装结构的立体化,即通常所说的3D组装技术。3D组装又称为立体或三维组装技术,是相对于平面组装而言的组装设计和工艺技术,在电子组装中早有应用,只不过近年由于产品微小型化要求越来越高而显得更为重要,并且在电子制造技术的快速发展和进步中有了新的发展。
3D组装技术主要有板级元器件3D组装和整机3D组装两个层级,这里只介绍板级元器件3D组装,整机3D组装将在后面章节介绍。
2.板级元器件3D组装
板级元器件3D组装就是在PCB上将元器件在Z方向堆叠安装,也称为PoP(package on package)或立体组装。早期的PoP采用标准周边引脚封装直接堆叠(见图5.5.16),随着IC封装技术的发展,BGA等面部引线封装应用越来越多,PoP也发展到面部引线封装的堆叠(见图5.5.17),这些封装的内部也可以是芯片内3D封装PiP(package in package),从而达到更高密度的电路结构。这种用于3D组装的封装是按照3D组装的要求封装的,例如图5.5.17中下面的BGA除了底部的焊球阵列外,封装上面还要制作焊盘以实现与上面BGA的互连组装。
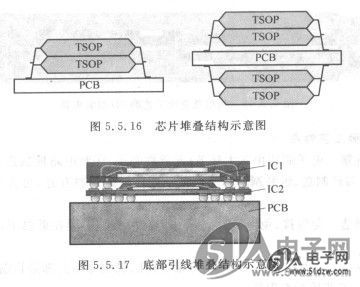
目前,板级元器件3D纽装已日益广泛地应用于数码相机、通信设备、手机等电子产品中,采用3D组装的比例逐年增加。板级立体组装在实现更好的电子学性能,提高空间利用率的同时也面临着更多复杂的设计和装配工艺技术的挑战。芯片堆叠要求更高的贴片和焊接精度及成熟的助焊剂工艺能力,抗干扰和热管理等技术也亟待进一步突破。在底部组装形式中,由于芯片与阻容器件之间的距离不到0.1mm,在焊接过程中热量在芯片和阻容器件间分布不均匀,为了实现芯片及其下部阻容器件的立体组装,需要对组装的总体流程方案进行设计,掌握焊盘设计技术、模板设计技术及阶梯焊接技术等。 D6406AID
板级元器件3D组装的优点:
①装配前各个器件可进行单独测试,从而保障了更高的良品率;
②可组合不同供应商的器件;
③总的堆叠制造成本可降至最低。
板级元器件3D组装的缺点:
①组装技术难度提高,要求更复杂的装配工艺和性能更高的设备;
②较高的装配外廓;
③检测困难。
上一篇:逆序组装技术
上一篇:连接是电子制造的关键技术



 公网安备44030402000607
公网安备44030402000607





