在芯片底部填充物基板和焊点之间分配而不是集中在外围焊点上
发布时间:2024/6/6 9:17:53 访问次数:70
底部填充物是一种液态封装物,通常是大量填充SiO2的环氧树脂,用于倒装芯片互连后的芯片和基底之间。固化后,硬化的底部填充物具有高模量、与焊点相匹配的低CTE 、低吸湿性以及与芯片和基板的良好粘合性。
焊点上的热应力在芯片、底部填充物、基板和所有焊点之间重新分配,而不是集中在外围焊点上。
此外,它还能保护焊点免受环境的侵蚀。底部填充是将倒装芯片技术的应用从陶瓷基板扩展到有机基板,从高端产品扩展到成本敏感型产品的一个切实可行的解决方案。

65-23x LXI高压开关产品族基于2U以太网控制的模块化机箱工作,这款机箱可配置最多六个插入式开关模块。
每个插入式模块最多可容纳50个具有与上述PXI系列相同的9kV规格的高压继电器。
9kV SPST开关实现了以小规模的结构提供高电压开关的目标。和旧的机架和堆叠式的仪器相比,新产品允许在尽可能最小的机架空间内搭建模块化和可扩展的测试系统。
XI平台上也提供大量的不同的配置选择,允许对开关系统进行裁剪以更适合测试系统的要求。
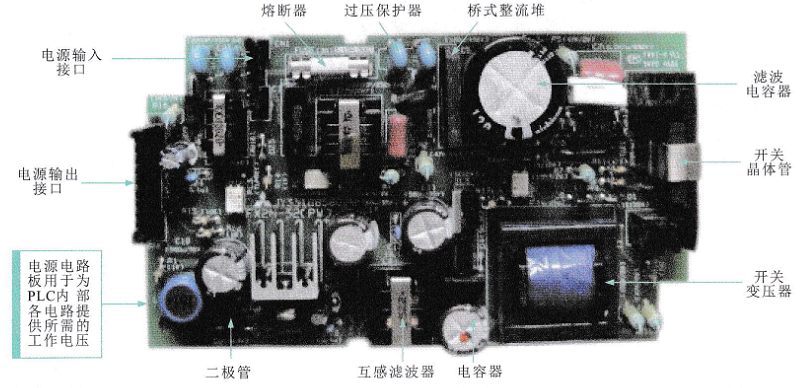
两款设备均支持BLE 5.2蓝牙连接,可以支持多种蓝牙配件,满足客户多种应用需求。两款设备广泛适用于车队管理、被盗车辆寻回(SVR)和UBI车险等业务场景。
受国际经济形势变化和疫情的影响,蜂窝网络技术部署演进的步伐出现了不均衡的局面,特别是在拉美地区。受经济发展影响,该地区网络基础建设呈现多样化。实践证明,应用底部填充可将最重要的焊点应变水平降低到未封装焊点应变的0.10-0.25。因此,底部填充可将焊点疲劳寿命提高10至100倍。
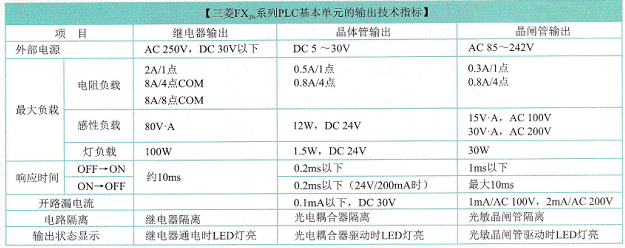
深圳市裕硕科技有限公司http://yushuo.51dzw.com
底部填充物是一种液态封装物,通常是大量填充SiO2的环氧树脂,用于倒装芯片互连后的芯片和基底之间。固化后,硬化的底部填充物具有高模量、与焊点相匹配的低CTE 、低吸湿性以及与芯片和基板的良好粘合性。
焊点上的热应力在芯片、底部填充物、基板和所有焊点之间重新分配,而不是集中在外围焊点上。
此外,它还能保护焊点免受环境的侵蚀。底部填充是将倒装芯片技术的应用从陶瓷基板扩展到有机基板,从高端产品扩展到成本敏感型产品的一个切实可行的解决方案。

65-23x LXI高压开关产品族基于2U以太网控制的模块化机箱工作,这款机箱可配置最多六个插入式开关模块。
每个插入式模块最多可容纳50个具有与上述I系列相同的9kV规格的高压继电器。
9kV SPST开关实现了以小规模的结构提供高电压开关的目标。和旧的机架和堆叠式的仪器相比,新产品允许在尽可能最小的机架空间内搭建模块化和可扩展的测试系统。
XI平台上也提供大量的不同的配置选择,允许对开关系统进行裁剪以更适合测试系统的要求。
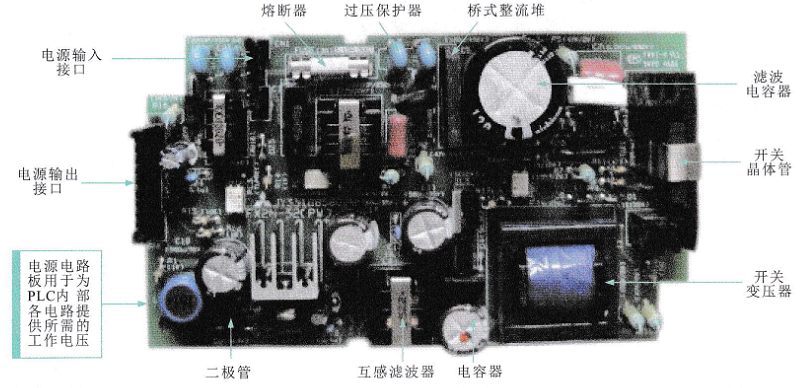
两款设备均支持BLE 5.2蓝牙连接,可以支持多种蓝牙配件,满足客户多种应用需求。两款设备广泛适用于车队管理、被盗车辆寻回(SVR)和UBI车险等业务场景。
受国际经济形势变化和疫情的影响,蜂窝网络技术部署演进的步伐出现了不均衡的局面,特别是在拉美地区。受经济发展影响,该地区网络基础建设呈现多样化。实践证明,应用底部填充可将最重要的焊点应变水平降低到未封装焊点应变的0.10-0.25。因此,底部填充可将焊点疲劳寿命提高10至100倍。
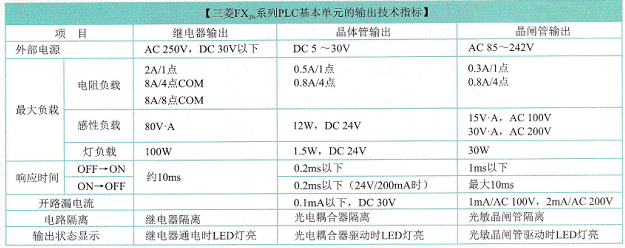
深圳市裕硕科技有限公司http://yushuo.51dzw.com



 公网安备44030402000607
公网安备44030402000607





